光刻胶是一大类具有光敏化学作用(或对电子能量敏感)的高分子聚合物材料,是转移紫外曝光或电子束曝照图案的媒介。在光刻工艺过程中,光刻胶被用作抗腐蚀涂层材料。半导体材料在表面加工时,若采用适当的有选择性的光刻胶,可在表面上得到所需的图像。在完成刻蚀或离子注入后,也要将半导体衬底上的光刻胶去除。那么,光刻胶的去除方法有哪些?
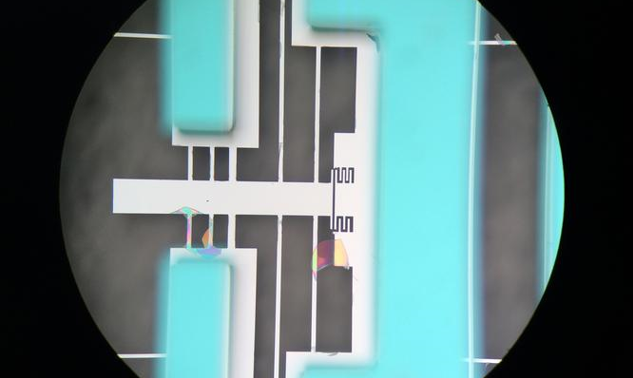
常用的去除光刻胶的方法有干法等离子体刻蚀和湿法清洗。
在干法等离子体刻蚀工艺中,产生等离子体的方法通过微波或射频等激励源作用于工作气体,例如氧气、氢气或含氟的气体,将该工作气体电离;并将半导体衬底上的光刻胶层暴露在等离子体气氛中,例如氧气等离子体中,通过等离子体气氛中的活性离子与光刻胶的反应、等离子体的轰击而将光刻胶去除。
然而,采用干法等离子体刻蚀去除光刻胶层容易使光刻胶下的材料层受到损伤,且费用较高,此外,由于干法等离子体刻蚀有时无法将光刻胶去除干净,完成干法等离子体刻蚀后还需再次用湿法清洗液进行清洗。
湿法清洗,是通过清洗液将半导体衬底表面的光刻胶去除。在湿法清洗中,通过将表面具有光刻胶的半导体衬底置于具有清洗液的容器中,或通过向光刻胶表面喷洒清洗液的方法去除光刻胶层。在现有的一种湿法清洗去除光刻胶的方法中,将双氧水注入到硫酸溶液中,双氧水与硫酸发生放热反应形成高温的清洗液;将该清洗液喷洒到半导体衬底的光刻胶表面,清洗液与光刻胶反应将光刻胶去除。接着,用去离子水冲洗去除光刻胶后的半导体衬底的表面。
